综述
1.7万次播放03:09芯片改变世界之二:集成电路有多牛?看看它的“手下败将”就知道集成电路,英文为Integrated Circuit,缩写为IC;顾名思义,就是把一定数量的常用电子元件,如电阻、电容、晶体管等,以及这些元件之间的连线,通过半导体工艺集成在一起的具有特定功能的电路。
为什么会产生集成电路?知道任何发明创造背后都是有驱动力的,而驱动力往往来源于问题。那么集成电路产生之前的问题是什么呢?看一下1946年在美国诞生的世界上第一台电子计算机,它是一个占地150平方米、重达30吨的庞然大物,里面的电路使用了17468只电子管、7200只电阻、10000只电容、50万条线,耗电量150千瓦 。显然,占用面积大、无法移动是它最直观和突出的问题;如果能把这些电子元件和连线集成在一小块载体上该有多好!相信,有很多人思考过这个问题,也提出过各种想法。典型的如英国雷达研究所的科学家达默,他在1952年的一次会议上提出:可以把电子线路中的分立元器件,集中制作在一块半导体晶片上,一小块晶片就是一个完整电路,这样一来,电子线路的体积就可大大缩小,可靠性大幅提高。这就是初期集成电路的构想,晶体管的发明使这种想法成为了可能,1947年在美国贝尔实验室制造出来了第一个晶体管,而在此之前要实现电流放大功能只能依靠体积大、耗电量大、结构脆弱的电子管。晶体管具有电子管的主要功能,并且克服了电子管的上述缺点,因此在晶体管发明后,很快就出现了基于半导体的集成电路的构想,也就很快发明出来了集成电路。杰克·基尔比(Jack Kilby)和罗伯特·诺伊斯(Robert Noyce)在1958~1959期间分别发明了锗集成电路和硅集成电路。
现在,集成电路已经在各行各业中发挥着非常重要的作用,是现代信息社会的基石。集成电路的含义,已经远远超过了其刚诞生时的定义范围,但其最核心的部分,仍然没有改变,那就是“集成”,其所衍生出来的各种学科,大都是围绕着“集成什么”、“如何集成”、“如何处理集成带来的利弊”这三个问题来开展的。硅集成电路是主流,就是把实现某种功能的电路所需的各种元件都放在一块硅片上,所形成的整体被称作集成电路。对于“集成”,想象一下住过的房子可能比较容易理解:很多人小时候都住过农村的房子,那时房屋的主体也许就是三两间平房,发挥着卧室的功能,门口的小院子摆上一副桌椅,就充当客厅,旁边还有个炊烟袅袅的小矮屋,那是厨房,而具有独特功能的厕所,需要有一定的隔离,有可能在房屋的背后,要走上十几米……后来,到了城市里,或者乡村城镇化,大家都住进了楼房或者套房,一套房里面,有客厅、卧室、厨房、卫生间、阳台,也许只有几十平方米,却具有了原来占地几百平方米的农村房屋的各种功能,这就是集成。
当然现如今的集成电路,其集成度远非一套房能比拟的,或许用一幢摩登大楼可以更好地类比:地面上有商铺、办公、食堂、酒店式公寓,地下有几层是停车场,停车场下面还有地基——这是集成电路的布局,模拟电路和数字电路分开,处理小信号的敏感电路与翻转频繁的控制逻辑分开,电源单独放在一角。每层楼的房间布局不一样,走廊也不一样,有回字形的、工字形的、几字形的——这是集成电路器件设计,低噪声电路中可以用折叠形状或“叉指”结构的晶体管来减小结面积和栅电阻。各楼层直接有高速电梯可达,为了效率和功能隔离,还可能有多部电梯,每部电梯能到的楼层不同——这是集成电路的布线,电源线、地线单独走线,负载大的线也宽;时钟与信号分开;每层之间布线垂直避免干扰;CPU与存储之间的高速总线,相当于电梯,各层之间的通孔相当于电梯间……

集成电路
集成电路在电路中用字母“IC”(也有用文字符号“N”等)表示。集成电路发明者为杰克•基尔比(Jack Kilby,1923年11月8日-2005年6月20日)。集成电路所有元件在结构上已组成一个整体,这样,整个电路的体积大大缩小,且引出线和焊接点的数目也大为减少,从而使电子元件向着微小型化、低功耗和高可靠性方面迈进了一大步。
《中国集成电路封装行业市场前瞻与投资战略规划分析报告前瞻》
显示,在产业规模快速增长的同时,IC 设计、芯片制造和封装测试三业的格局也正不断优化。2010年,国内IC设计业同比增速达到34.8%,规模达到363.85亿元;芯片制造业增速也达到31.1%,规模达到447.12亿元;封装测试业增速相对稍缓,同比增幅为26.3%,规模为629.18亿元。总体来看,IC设计业与芯片制造业所占比重呈逐年上升的趋势,2010年已分别达到25.3%和31%;封装测试业所占比重则相应下降,2010年为43.7%,但其所占比重依然是最大的。
目前,中国集成电路产业集群已初步形成集聚长三角、环渤海和珠三角三大区域的总体产业空间格局,2010年三大区域集成电路产业销售收入占全国整体产业规模的近95%。集成电路产业基本分布在省会城市和沿海的计划单列市,并呈现“一轴一带”的分布特征,即东起上海、西至成都的沿江发展轴以及北起大连、南至深圳的沿海产业带,形成了北京、上海、深圳、无锡、苏州和杭州六大重点城市。
国务院发布了《国务院关于印发进一步鼓励软件产业和集成电路产业发展若干政策的通知》,从财税、投融资、研发、进出口、人才、知识产权等方面给予集成电路产业诸多优惠,政策覆盖范围从设计企业与生产企业延伸至封装、测试、设备、材料等产业链上下游企业,产业发展政策环境进一步好转。前瞻网表示,根据国家规划,到2015年国内集成电路产业规模将在2010年的基础上再翻一番,销售收入超过3000亿元,满足国内30%的市场需求。芯片设计能力大幅提升,开发出一批具有自主知识产权的核心芯片,而封装测试业进入国际主流领域。“十二五”期间,中国集成电路产业将步入一个新的黄金发展期。
集成电路或称微电路(microcircuit)、微芯片(microchip)、芯片(chip)在电子学中是一种把电路(主要包括半导体装置,也包括被动元件等)小型化的方式,并通常制造在半导体晶圆表面上。
前述将电路制造在半导体芯片表面上的集成电路又称薄膜(thin-film)集成电路。另有一种厚膜(thick-film)混成集成电路(hybrid integrated circuit)是由独立半导体设备和被动元件,集成到衬底或线路板所构成的小型化电路。
本文是关于单片(monolithic)集成电路,即薄膜集成电路。
集成电路具有体积小,重量轻,引出线和焊接点少,寿命长,可靠性高,性能好等优点,同时成本低,便于大规模生产。它不仅在工、民用电子设备如收录机、电视机、计算机等方面得到广泛的应用,同时在军事、通讯、遥控等方面也得到广泛的应用。用集成电路来装配电子设备,其装配密度比晶体管可提高几十倍至几千倍,设备的稳定工作时间也可大大提高。

集成电路
(一)按功能结构分类集成电路按其功能、结构的不同,可以分为模拟集成电路、数字集成电路和数/模混合集成电路三大类。
模拟集成电路用来产生、放大和处理各种模拟信号(指幅度随时间边疆变化的信号。例如半导体收音机的音频信号、录放机的磁带信号等),而数字集成电路用来产生、放大和处理各种数字信号(指在时间上和幅度上离散取值的信号。例如VCD、DVD重放的音频信号和视频信号)。
(二)按制作工艺分类
集成电路按制作工艺可分为半导体集成电路和薄膜集成电路。
膜集成电路又分类厚膜集成电路和薄膜集成电路。

集成电路
(三)按集成度高低分类集成电路按集成度高低的不同可分为小规模集成电路、中规模集成电路、大规模集成电路、超大规模集成电路、特大规模集成电路和巨大规模集成电路。
(四)按导电类型不同分类
集成电路按导电类型可分为双极型集成电路和单极型集成电路。
双极型集成电路的制作工艺复杂,功耗较大,代表集成电路有TTL、ECL、HTL、LST-TL、STTL等类型。单极型集成电路的制作工艺简单,功耗也较低,易于制成大规模集成电路,代表集成电路有CMOS、NMOS、PMOS等类型。
(五)按用途分类
集成电路按用途可分为电视机用集成电路、音响用集成电路、影碟机用集成电路、录像机用集成电路、电脑(微机)用集成电路、电子琴用集成电路、通信用集成电路、照相机用集成电路、遥控集成电路、语言集成电路、报警器用集成电路及各种专用集成电路。
1、电视机用集成电路包括行、场扫描集成电路、中放集成电路、伴音集成电路、彩色解码集成电路、AV/TV转换集成电路、开关电源集成电路、遥控集成电路、丽音解码集成电路、画中画处理集成电路、微处理器(CPU)集成电路、存储器集成电路等。
2、音响用集成电路包括AM/FM高中频电路、立体声解码电路、音频前置放大电路、音频运算放大集成电路、音频功率放大集成电路、环绕声处理集成电路、电平驱动集成电路,电子音量控制集成电路、延时混响集成电路、电子开关集成电路等。
3、影碟机用集成电路有系统控制集成电路、视频编码集成电路、MPEG解码集成电路、音频信号处理集成电路、音响效果集成电路、RF信号处理集成电路、数字信号处理集成电路、伺服集成电路、电动机驱动集成电路等。
4、录像机用集成电路有系统控制集成电路、伺服集成电路、驱动集成电路、音频处理集成电路、视频处理集成电路。
(六)按大小分
有小规模集成电路
大规模集成电路
超大规模集成电路
(七)按应用领域分
集成电路按应用领域可分为标准通用集成电路和专用集成电路。
(ba)按外形分
集成电路按外形可分为圆形(金属外壳晶体管封装型,一般适合用于大功率)、扁平型(稳定性好,体积小)和双列直插型。
世界集成电路的发展历史1947年:贝尔实验室肖克莱等人发明了晶体管,这是微电子技术发展中第一个里程碑;
1950年:结型晶体管诞生;
1950年:ROhl和肖特莱发明了离子注入工艺;
1951年:场效应晶体管发明;
1956年:CSFuller发明了扩散工艺;
1958年:仙童公司RobertNoyce与德仪公司基尔比间隔数月分别发明了集成电路,开创了世界微电子学的历史;
1960年:HHLoor和ECastellani发明了光刻工艺;
1962年:美国RCA公司研制出MOS场效应晶体管;
1963年:F.M.Wanlass和C.T.Sah首次提出CMOS技术,今天,95%以上的集成电路芯片都是基于CMOS工艺;
1964年:Intel摩尔提出摩尔定律,预测晶体管集成度将会每18个月增加1倍;
1966年:美国RCA公司研制出CMOS集成电路,并研制出第一块门阵列(50门);
1967年:应用材料公司(AppliedMaterials)成立,现已成为全球最大的半导体设备制造公司;
1971年:Intel推出1kb动态随机存储器(DRAM),标志着大规模集成电路出现;
1971年:全球第一个微处理器4004由Intel公司推出,采用的是MOS工艺,这是一个里程碑式的发明;
1974年:RCA公司推出第一个CMOS微处理器1802;
1976年:16kbDRAM和4kbSRAM问世;
1978年:64kb动态随机存储器诞生,不足0.5平方厘米的硅片上集成了14万个晶体管,标志着超大规模集成电路(VLSI)时代的来临;
1979年:Intel推出5MHz8088微处理器,之后,IBM基于8088推出全球第一台PC;
1981年:256kbDRAM和64kbCMOSSRAM问世;
1984年:日本宣布推出1MbDRAM和256kbSRAM;
1985年:80386微处理器问世,20MHz;

集成电路
1988年:16MDRAM问世,1平方厘米大小的硅片上集成有3500万个晶体管,标志着进入超大规模集成电路(ULSI)阶段;1989年:1MbDRAM进入市场;
1989年:486微处理器推出,25MHz,1μm工艺,后来50MHz芯片采用0.8μm工艺;
1992年:64M位随机存储器问世;
1993年:66MHz奔腾处理器推出,采用0.6μm工艺;
1995年:PentiumPro,133MHz,采用0.6-0.35μm工艺;
1997年:300MHz奔腾Ⅱ问世,采用0.25μm工艺;
1999年:奔腾Ⅲ问世,450MHz,采用0.25μm工艺,后采用0.18μm工艺;
2000年:1GbRAM投放市场;
2000年:奔腾4问世,1.5GHz,采用0.18μm工艺;
2001年:Intel宣布2001年下半年采用0.13μm工艺。
2003年:奔腾4 E系列推出,采用90nm工艺。
2005年:intel 酷睿2系列上市,采用65nm工艺。
2007年:基于全新45纳米High-K工艺的intel酷睿2 E7/E8/E9上市。
2009年:intel酷睿i系列全新推出,创纪录采用了领先的32纳米工艺,并且下一代22纳米工艺正在研发。
中国集成电路的发展历史
中国集成电路产业诞生于六十年代,共经历了三个发展阶段:
1965年-1978年:以计算机和军工配套为目标,以开发逻辑电路为主要产品,初步建立集成电路工业基础及相关设备、仪器、材料的配套条件;
1978年-1990年:主要引进美国二手设备,改善集成电路装备水平,在“治散治乱”的同时,以消费类整机作为配套重点,较好地解决了彩电集成电路的国产化;
1990年-2000年:以908工程、909工程为重点,以CAD为突破口,抓好科技攻关和北方科研开发基地的建设,为信息产业服务,集成电路行业取得了新的发展。
集成电路产业是对集成电路产业链各环节市场销售额的总体描述,它不仅仅包含集成电路市场,也包括IP核市场、EDA市场、芯片代工市场、封测市场,甚至延伸至设备、材料市场。
集成电路产业不再依赖CPU、存储器等单一器件发展,移动互联、三网融合、多屏互动、智能终端带来了多重市场空间,商业模式不断创新为市场注入新活力。目前中国集成电路产业已具备一定基础,多年来中国集成电路产业所聚集的技术创新活力、市场拓展能力、资源整合动力以及广阔的市场潜力,为产业在未来5年~10年实现快速发展、迈上新的台阶奠定了基础。
型号命名
中国集成电路的型号 根据国际,中国集成电路的命名由五部分组成。
第0部分 第一部分 第二部分 第三部分 第四部分
各部分的含义如下
第0部分:用字母表示符合国家标准,C表示中国国际产品。
第一部分:用字母表示器件类型。
第二部分:用数字表示器件的系列代号。
第三部分:用字母表示器件的工作温度。
第四部分:用字母表示器件的封装。
国标GB/T3430—1989半导体集成电路命名方法规定集成电路型号各部分的符合及意义。
例如:肖特基4输入与非门 CT54S20MD
C—符合国家标准
T—TTL电路
54S20—肖特基双4输入与非门
M—‐55~125℃
D—多层陶瓷双列直插封装
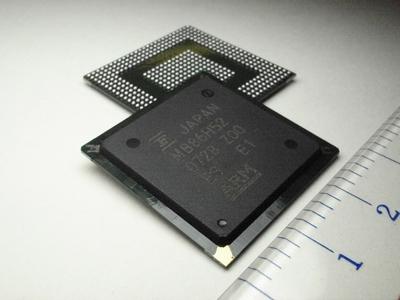
集成电路
1、BGA(ballgridarray)球形触点陈列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI芯片,然后用模压树脂或灌封方法进行密封。也称为凸点陈列载体(PAC)。引脚可超过200,是多引脚LSI用的一种封装。封装本体也可做得比QFP(四侧引脚扁平封装)小。例如,引脚中心距为1.5mm的360引脚BGA仅为31mm见方;而引脚中心距为0.5mm的304引脚QFP为40mm见方。而且BGA不用担心QFP那样的引脚变形问题。该封装是美国Motorola公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。最初,BGA的引脚(凸点)中心距为1.5mm,引脚数为225。现在也有一些LSI厂家正在开发500引脚的BGA。BGA的问题是回流焊后的外观检查。现在尚不清楚是否有效的外观检查方法。有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。美国Motorola公司把用模压树脂密封的封装称为OMPAC,而把灌封方法密封的封装称为GPAC(见OMPAC和GPAC)。
2、BQFP(quadflatpackagewithbumper)
带缓冲垫的四侧引脚扁平封装。QFP封装之一,在封装本体的四个角设置突起(缓冲垫)以防止在运送过程中引脚发生弯曲变形。美国半导体厂家主要在微处理器和ASIC等电路中采用此封装。引脚中心距0.635mm,引脚数从84到196左右(见QFP)。
4、C-(ceramic)
表示陶瓷封装的记号。例如,CDIP表示的是陶瓷DIP。是在实际中经常使用的记号。
5、Cerdip
用玻璃密封的陶瓷双列直插式封装,用于ECLRAM,DSP(数字信号处理器)等电路。带有玻璃窗口的Cerdip用于紫外线擦除型EPROM以及内部带有EPROM的微机电路等。引脚中心距2.54mm,引脚数从8到42。在日本,此封装表示为DIP-G(G即玻璃密封的意思)。
6、Cerquad
表面贴装型封装之一,即用下密封的陶瓷QFP,用于封装DSP等的逻辑LSI电路。带有窗口的Cerquad用于封装EPROM电路。散热性比塑料QFP好,在自然空冷条件下可容许1.5~2W的功率。但封装成本比塑料QFP高3~5倍。引脚中心距有1.27mm、0.8mm、0.65mm、0.5mm、0.4mm等多种规格。引脚数从32到368。
带引脚的陶瓷芯片载体,表面贴装型封装之一,引脚从封装的四个侧面引出,呈丁字形。带有窗口的用于封装紫外线擦除型EPROM以及带有EPROM的微机电路等。此封装也称为QFJ、QFJ-G(见QFJ)。

集成电路
8、COB(chiponboard)板上芯片封装,是裸芯片贴装技术之一,半导体芯片交接贴装在印刷线路板上,芯片与基板的电气连接用引线缝合方法实现,芯片与基板的电气连接用引线缝合方法实现,并用树脂覆盖以确保可靠性。虽然COB是最简单的裸芯片贴装技术,但它的封装密度远不如TAB和倒片焊技术。
9、DFP(dualflatpackage)
双侧引脚扁平封装。是SOP的别称(见SOP)。以前曾有此称法,现在已基本上不用。
10、DIC(dualin-lineceramiCPACkage)
陶瓷DIP(含玻璃密封)的别称(见DIP).
11、DIL(dualin-line)
DIP的别称(见DIP)。欧洲半导体厂家多用此名称。
12、DIP(dualin-linepackage)
双列直插式封装。插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。DIP是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。引脚中心距2.54mm,引脚数从6到64。封装宽度通常为15.2mm。有的把宽度为7.52mm和10.16mm的封装分别称为skinnyDIP和slimDIP(窄体型DIP)。但多数情况下并不加区分,只简单地统称为DIP。另外,用低熔点玻璃密封的陶瓷DIP也称为cerdip(见cerdip)。
13、DSO(dualsmallout-lint)
双侧引脚小外形封装。SOP的别称(见SOP)。部分半导体厂家采用此名称。
14、dicp(dualtapecarrierpackage)
双侧引脚带载封装。TCP(带载封装)之一。引脚制作在绝缘带上并从封装两侧引出。由于利用的是TAB(自动带载焊接)技术,封装外形非常薄。常用于液晶显示驱动LSI,但多数为定制品。另外,0.5mm厚的存储器LSI簿形封装正处于开发阶段。在日本,按照EIAJ(日本电子机械工业)会标准规定,将DICP命名为DTP。
15、DIP(dualtapecarrierpackage)
同上。日本电子机械工业会标准对DTCP的命名(见DTCP)。
16、FP(flatpackage)
扁平封装。表面贴装型封装之一。QFP或SOP(见QFP和SOP)的别称。部分半导体厂家采用此名称。
17、flip-chip
倒焊芯片。裸芯片封装技术之一,在LSI芯片的电极区制作好金属凸点,然后把金属凸点与印刷基板上的电极区进行压焊连接。封装的占有面积基本上与芯片尺寸相同。是所有封装技术中体积最小、最薄的一种。但如果基板的热膨胀系数与LSI芯片不同,就会在接合处产生反应,从而影响连接的可靠性。因此必须用树脂来加固LSI芯片,并使用热膨胀系数基本相同的基板材料。

集成电路
18、fQFP(finepitchquadflatpackage)小引脚中心距QFP。通常指引脚中心距小于0.65mm的QFP(见QFP)。部分导导体厂家采用此名称。
19、CPAC(globetoppadarraycarrier)
美国Motorola公司对BGA的别称(见BGA)。
20、CQFP(quadfiatpackagewithguardring)
带保护环的四侧引脚扁平封装。塑料QFP之一,引脚用树脂保护环掩蔽,以防止弯曲变形。在把LSI组装在印刷基板上之前,从保护环处切断引脚并使其成为海鸥翼状(L形状)。这种封装在美国Motorola公司已批量生产。引脚中心距0.5mm,引脚数最多为208左右。
21、H-(withheatsink)
表示带散热器的标记。例如,HSOP表示带散热器的SOP。
22、pingridarray(surfacemounttype)
表面贴装型PGA。通常PGA为插装型封装,引脚长约3.4mm。表面贴装型PGA在封装的底面有陈列状的引脚,其长度从1.5mm到2.0mm。贴装采用与印刷基板碰焊的方法,因而也称为碰焊PGA。因为引脚中心距只有1.27mm,比插装型PGA小一半,所以封装本体可制作得不怎么大,而引脚数比插装型多(250~528),是大规模逻辑LSI用的封装。封装的基材有多层陶瓷基板和玻璃环氧树脂印刷基数。以多层陶瓷基材制作封装已经实用化。
23、jlcc(J-leadedchipcarrier)
J形引脚芯片载体。指带窗口CLCC和带窗口的陶瓷QFJ的别称(见CLCC和QFJ)。部分半导体厂家采用的名称。
24、LCC(Leadlesschipcarrier)
无引脚芯片载体。指陶瓷基板的四个侧面只有电极接触而无引脚的表面贴装型封装。是高速和高频IC用封装,也称为陶瓷QFN或QFN-C(见QFN)。
25、LGA(landgridarray)
触点陈列封装。即在底面制作有阵列状态坦电极触点的封装。装配时插入插座即可。现已实用的有227触点(1.27mm中心距)和447触点(2.54mm中心距)的陶瓷LGA,应用于高速逻辑LSI电路。LGA与QFP相比,能够以比较小的封装容纳更多的输入输出引脚。另外,由于引线的阻抗小,对于高速LSI是很适用的。但由于插座制作复杂,成本高,现在基本上不怎么使用。预计今后对其需求会有所增加。
26、LOC(leadonchip)
芯片上引线封装。LSI封装技术之一,引线框架的前端处于芯片上方的一种结构,芯片的中心附近制作有凸焊点,用引线缝合进行电气连接。与原来把引线框架布置在芯片侧面附近的结构相比,在相同大小的封装中容纳的芯片达1mm左右宽度。

集成电路
27、LQFP(lowprofilequadflatpackage)薄型QFP。指封装本体厚度为1.4mm的QFP,是日本电子机械工业会根据制定的新QFP外形规格所用的名称。
28、L-QUAD
陶瓷QFP之一。封装基板用氮化铝,基导热率比氧化铝高7~8倍,具有较好的散热性。封装的框架用氧化铝,芯片用灌封法密封,从而抑制了成本。是为逻辑LSI开发的一种封装,在自然空冷条件下可容许W3的功率。现已开发出了208引脚(0.5mm中心距)和160引脚(0.65mm中心距)的LSI逻辑用封装,并于1993年10月开始投入批量生产。
29、MCM(multi-chipmodule)
多芯片组件。将多块半导体裸芯片组装在一块布线基板上的一种封装。根据基板材料可分为MCM-L,MCM-C和MCM-D三大类。MCM-L是使用通常的玻璃环氧树脂多层印刷基板的组件。布线密度不怎么高,成本较低。MCM-C是用厚膜技术形成多层布线,以陶瓷(氧化铝或玻璃陶瓷)作为基板的组件,与使用多层陶瓷基板的厚膜混合IC类似。两者无明显差别。布线密度高于MCM-L。
MCM-D是用薄膜技术形成多层布线,以陶瓷(氧化铝或氮化铝)或Si、Al作为基板的组件。布线密谋在三种组件中是最高的,但成本也高。
30、MFP(miniflatpackage)
小形扁平封装。塑料SOP或SSOP的别称(见SOP和SSOP)。部分半导体厂家采用的名称。
31、MQFP(metricquadflatpackage)
按照JEDEC(美国联合电子设备委员会)标准对QFP进行的一种分类。指引脚中心距为0.65mm、本体厚度为3.8mm~2.0mm的标准QFP(见QFP)。
32、MQUAD(metalquad)
美国Olin公司开发的一种QFP封装。基板与封盖均采用铝材,用粘合剂密封。在自然空冷条件下可容许2.5W~2.8W的功率。日本新光电气工业公司于1993年获得特许开始生产。
33、MSP(minisquarepackage)
QFI的别称(见QFI),在开发初期多称为MSP。QFI是日本电子机械工业会规定的名称。
34、OPMAC(overmoldedpadarraycarrier)
模压树脂密封凸点陈列载体。美国Motorola公司对模压树脂密封BGA采用的名称(见BGA)。
35、P-(plastic)
表示塑料封装的记号。如PDIP表示塑料DIP。
36、PAC(padarraycarrier)
凸点陈列载体,BGA的别称(见BGA)。
37、PCLP(printedcircuitboardleadlesspackage)
印刷电路板无引线封装。日本富士通公司对塑料QFN(塑料LCC)采用的名称(见QFN)。引
脚中心距有0.55mm和0.4mm两种规格。目前正处于开发阶段。
38、pfpf(plasticflatpackage)
塑料扁平封装。塑料QFP的别称(见QFP)。部分LSI厂家采用的名称。

集成电路
39、PGA(pingridarray)陈列引脚封装。插装型封装之一,其底面的垂直引脚呈陈列状排列。封装基材基本上都采用多层陶瓷基板。在未专门表示出材料名称的情况下,多数为陶瓷PGA,用于高速大规模逻辑LSI电路。成本较高。引脚中心距通常为2.54mm,引脚数从64到447左右。了为降低成本,封装基材可用玻璃环氧树脂印刷基板代替。也有64~256引脚的塑料PGA。另外,还有一种引脚中心距为1.27mm的短引脚表面贴装型PGA(碰焊PGA)。(见表面贴装型PGA)。
40、piggyback
驮载封装。指配有插座的陶瓷封装,形关与DIP、QFP、QFN相似。在开发带有微机的设备时用于评价程序确认操作。例如,将EPROM插入插座进行调试。这种封装基本上都是定制品,市场上不怎么流通。
41、PLCC(plasticleadedchipcarrier)
带引线的塑料芯片载体。表面贴装型封装之一。引脚从封装的四个侧面引出,呈丁字形,是塑料制品。美国德克萨斯仪器公司首先在64k位DRAM和256kDRAM中采用,现在已经普及用于逻辑LSI、DLD(或程逻辑器件)等电路。引脚中心距1.27mm,引脚数从18到84。J形引脚不易变形,比QFP容易操作,但焊接后的外观检查较为困难。PLCC与LCC(也称QFN)相似。以前,两者的区别仅在于前者用塑料,后者用陶瓷。但现在已经出现用陶瓷制作的J形引脚封装和用塑料制作的无引脚封装(标记为塑料LCC、PCLP、P-LCC等),已经无法分辨。为此,日本电子机械工业会于1988年决定,把从四侧引出J形引脚的封装称为QFJ,把在四侧带有电极凸点的封装称为QFN(见QFJ和QFN)。
42、P-LCC(plasticteadlesschipcarrier)(plasticleadedchipcurrier)
有时候是塑料QFJ的别称,有时候是QFN(塑料LCC)的别称(见QFJ和QFN)。部分
LSI厂家用PLCC表示带引线封装,用P-LCC表示无引线封装,以示区别。
43、QFH(quadflathighpackage)
四侧引脚厚体扁平封装。塑料QFP的一种,为了防止封装本体断裂,QFP本体制作得较厚(见QFP)。部分半导体厂家采用的名称。
44、QFI(quadflatI-leadedpackgac)
四侧I形引脚扁平封装。表面贴装型封装之一。引脚从封装四个侧面引出,向下呈I字。也称为MSP(见MSP)。贴装与印刷基板进行碰焊连接。由于引脚无突出部分,贴装占有面积小于QFP。日立制作所为视频模拟IC开发并使用了这种封装。此外,日本的Motorola公司的PLLIC也采用了此种封装。引脚中心距1.27mm,引脚数从18于68。
45、QFJ(quadflatJ-leadedpackage)
四侧J形引脚扁平封装。表面贴装封装之一。引脚从封装四个侧面引出,向下呈J字形。是日本电子机械工业会规定的名称。引脚中心距1.27mm。
材料有塑料和陶瓷两种。塑料QFJ多数情况称为PLCC(见PLCC),用于微机、门陈列、DRAM、ASSP、OTP等电路。引脚数从18至84。
陶瓷QFJ也称为CLCC、JLCC(见CLCC)。带窗口的封装用于紫外线擦除型EPROM以及带有EPROM的微机芯片电路。引脚数从32至84。

集成电路
46、QFN(quadflatnon-leadedpackage)四侧无引脚扁平封装。表面贴装型封装之一。现在多称为LCC。QFN是日本电子机械工业会规定的名称。封装四侧配置有电极触点,由于无引脚,贴装占有面积比QFP小,高度比QFP低。但是,当印刷基板与封装之间产生应力时,在电极接触处就不能得到缓解。因此电极触点难于作到QFP的引脚那样多,一般从14到100左右。材料有陶瓷和塑料两种。当有LCC标记时基本上都是陶瓷QFN。电极触点中心距1.27mm。
塑料QFN是以玻璃环氧树脂印刷基板基材的一种低成本封装。电极触点中心距除1.27mm外,还有0.65mm和0.5mm两种。这种封装也称为塑料LCC、PCLC、P-LCC等。
47、QFP(quadflatpackage)
四侧引脚扁平封装。表面贴装型封装之一,引脚从四个侧面引出呈海鸥翼(L)型。基材有陶瓷、金属和塑料三种。从数量上看,塑料封装占绝大部分。当没有特别表示出材料时,多数情况为塑料QFP。塑料QFP是最普及的多引脚LSI封装。不仅用于微处理器,门陈列等数字逻辑LSI电路,而且也用于VTR信号处理、音响信号处理等模拟LSI电路。引脚中心距有1.0mm、0.8mm、0.65mm、0.5mm、0.4mm、0.3mm等多种规格。0.65mm中心距规格中最多引脚数为304。
日本将引脚中心距小于0.65mm的QFP称为QFP(FP)。但现在日本电子机械工业会对QFP的外形规格进行了重新评价。在引脚中心距上不加区别,而是根据封装本体厚度分为QFP(2.0mm~3.6mm厚)、LQFP(1.4mm厚)和TQFP(1.0mm厚)三种。
另外,有的LSI厂家把引脚中心距为0.5mm的QFP专门称为收缩型QFP或SQFP、VQFP。但有的厂家把引脚中心距为0.65mm及0.4mm的QFP也称为SQFP,至使名称稍有一些混乱。QFP的缺点是,当引脚中心距小于0.65mm时,引脚容易弯曲。为了防止引脚变形,现已出现了几种改进的QFP品种。如封装的四个角带有树指缓冲垫的BQFP(见BQFP);带树脂保护环覆盖引脚前端的GQFP(见GQFP);在封装本体里设置测试凸点、放在防止引脚变形的专用夹具里就可进行测试的TPQFP(见TPQFP)。在逻辑LSI方面,不少开发品和高可靠品都封装在多层陶瓷QFP里。引脚中心距最小为0.4mm、引脚数最多为348的产品也已问世。此外,也有用玻璃密封的陶瓷QFP(见Gerqad)。
48、QFP(FP)(QFPfinepitch)
小中心距QFP。日本电子机械工业会标准所规定的名称。指引脚中心距为0.55mm、0.4mm、0.3mm等小于0.65mm的QFP(见QFP)。
49、QIC(quadin-lineceramicpackage)
陶瓷QFP的别称。部分半导体厂家采用的名称(见QFP、Cerquad)。
50、QIP(quadin-lineplasticpackage)
塑料QFP的别称。部分半导体厂家采用的名称(见QFP)。
51、QTCP(quadtapecarrierpackage)
四侧引脚带载封装。TCP封装之一,在绝缘带上形成引脚并从封装四个侧面引出。是利用TAB技术的薄型封装(见TAB、TCP)。

集成电路
52、QTP(quadtapecarrierpackage)四侧引脚带载封装。日本电子机械工业会于1993年4月对QTCP所制定的外形规格所用的名称(见TCP)。
53、QUIL(quadin-line)
quip的别称(见QUIP)。
54、QUIP(quadin-linepackage)
四列引脚直插式封装。引脚从封装两个侧面引出,每隔一根交错向下弯曲成四列。引脚中心距1.27mm,当插入印刷基板时,插入中心距就变成2.5mm。因此可用于标准印刷线路板。是比标准DIP更小的一种封装。日本电气公司在台式计算机和家电产品等的微机芯片中采用了些种封装。材料有陶瓷和塑料两种。引脚数64。
55、SDIP(shrinkdualin-linepackage)
收缩型DIP。插装型封装之一,形状与DIP相同,但引脚中心距(1.778mm)小于DIP(2.54mm),
因而得此称呼。引脚数从14到90。也有称为SH-DIP的。材料有陶瓷和塑料两种。
56、SH-DIP(shrinkdualin-linepackage)
同SDIP。部分半导体厂家采用的名称。
57、SIL(singlein-line)
SIP的别称(见SIP)。欧洲半导体厂家多采用SIL这个名称。
58、SIMM(singlein-linememorymodule)
单列存贮器组件。只在印刷基板的一个侧面附近配有电极的存贮器组件。通常指插入插座的组件。标准SIMM有中心距为2.54mm的30电极和中心距为1.27mm的72电极两种规格。在印刷基板的单面或双面装有用SOJ封装的1兆位及4兆位DRAM的SIMM已经在个人计算机、工作站等设备中获得广泛应用。至少有30~40%的DRAM都装配在SIMM里。
59、SIP(singlein-linepackage)
单列直插式封装。引脚从封装一个侧面引出,排列成一条直线。当装配到印刷基板上时封装呈侧立状。引脚中心距通常为2.54mm,引脚数从2至23,多数为定制产品。封装的形状各异。也有的把形状与ZIP相同的封装称为SIP。
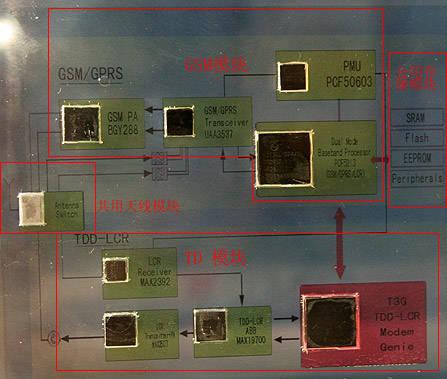
集成电路
60、SK-DIP(skinnydualin-linepackage)DIP的一种。指宽度为7.62mm、引脚中心距为2.54mm的窄体DIP。通常统称为DIP(见DIP)。
61、SL-DIP(slimdualin-linepackage)
DIP的一种。指宽度为10.16mm,引脚中心距为2.54mm的窄体DIP。通常统称为DIP。
62、SMD(surfacemountdevices)
表面贴装器件。偶而,有的半导体厂家把SOP归为SMD(见SOP)。
SOP的别称。世界上很多半导体厂家都采用此别称。(见SOP)。
64、SOI(smallout-lineI-leadedpackage)
I形引脚小外型封装。表面贴装型封装之一。引脚从封装双侧引出向下呈I字形,中心距1.27mm。贴装占有面积小于SOP。日立公司在模拟IC(电机驱动用IC)中采用了此封装。引脚数26。
65、SOIC(smallout-lineintegratedcircuit)
SOP的别称(见SOP)。国外有许多半导体厂家采用此名称。
66、SOJ(SmallOut-LineJ-LeadedPackage)
J形引脚小外型封装。表面贴装型封装之一。引脚从封装两侧引出向下呈J字形,故此得名。通常为塑料制品,多数用于DRAM和SRAM等存储器LSI电路,但绝大部分是DRAM。用SOJ封装的DRAM器件很多都装配在SIMM上。引脚中心距1.27mm,引脚数从20至40(见SIMM)。
67、SQL(SmallOut-LineL-leadedpackage)
按照JEDEC(美国联合电子设备工程委员会)标准对SOP所采用的名称(见SOP)。
68、SONF(SmallOut-LineNon-Fin)
无散热片的SOP。与通常的SOP相同。为了在功率IC封装中表示无散热片的区别,有意增添了NF(non-fin)标记。部分半导体厂家采用的名称(见SOP)。
69、SOP(smallOut-Linepackage)
小外形封装。表面贴装型封装之一,引脚从封装两侧引出呈海鸥翼状(L字形)。材料有塑料和陶瓷两种。另外也叫SOL和DFP。
SOP除了用于存储器LSI外,也广泛用于规模不太大的ASSP等电路。在输入输出端子不超过10~40的领域,SOP是普及最广的表面贴装封装。引脚中心距1.27mm,引脚数从8~44。
另外,引脚中心距小于1.27mm的SOP也称为SSOP;装配高度不到1.27mm的SOP也称为TSOP(见SSOP、TSOP)。还有一种带有散热片的SOP。
70、SOW(SmallOutlinePackage(Wide-Jype))
宽体SOP。部分半导体厂家采用的名称。
检测技巧
通常一台设备里面有许多个集成电路,当拿到一部有故障的集成电路的设备时,想要找到故障所在必须通过检测,集成电路行之有效的检测方法包括:
1.微处理器集成电路的检测
微处理器集成电路的关键测试引脚是VDD电源端、RESET复位端、XIN 晶振信号输入端、XOUT晶振信号输出端及其他各线输入、输出端。在路测量这些关键脚对地的电阻值和电压值,看是否与正常值(可从产品电路图或有关维修资 料中查出)相同。不同型号微处理器的RESET复位电压也不相同,有的是低电平复位,即在开机瞬间为低电平,复位后维持高电平;有的是高电平复位,即在开 关瞬间为高电平,复位后维持低电平。
2.开关电源集成电路的检测
开关电源集成电路的关键脚电压是电源端(VCC)、激励脉冲输出端、电压检测输入端、电流检测输入端。测量各引脚对地的电压值和电阻值,若与正常值相差较大,在其外围元器件正常的情况下,可以确定是该集成电路已损坏。内置大功率开关管的厚膜集成电路,还可通过测量开关管C、B、E极之间的正、反向电阻值,来判断开关管是否正常。
3.音频功放集成电路的检测
检查音频功放集成电路时,应先检测其电源端(正电源端和负电源端)、音频 输入端、音频输出端及反馈端对地的电压值和电阻值。若测得各引脚的数据值与正常值相差较大,其外围元件与正常,则是该集成电路内部损坏。对引起无声故障的 音频功放集成电路,测量其电源电压正常时,可用信号干扰法来检查。测量时,万用表应置于R×1档,将红表笔接地,用黑表笔点触音频输入端,正常时扬声器中 应有较强的“喀喀”声。
4.运算放大器集成电路的检测
用万用表直流电压档,测量运算放大器输出端与负电源端之间的电压值(在静态时电压值较高)。用手持金属镊子依次点触运算放大器的两个输入端(加入干扰信号),若万用表表针有较大幅度的摆动,则说明该运算放大器完好;若万用表表针不动,则说明运算放大器已损坏。
5.时基集成电路的检测
时基集成电路内含数字电路和模拟电路,用万用表很难直接测出其好坏。测试电路由阻容元件、发光二极管LED、6V直流电源、电源开关S和8脚IC插座组成。将时基集 成电路(例如NE555)插信IC插座后,按下电源开关S,若被测时基集成电路正常,则发光二极管LED将闪烁发光;若LED不亮或一直亮,则说明被测时基集成电路性能不良。
检测常识1、检测前要了解集成电路及其相关电路的工作原理。检查和修理集成电路前首先要熟悉所用集成电路的功能、内部电路、主要电气参数、各引脚的作用以及引脚的正常电压、波形与外围元件组成电路的工作原理。如果具备以上条件,那么分析和检查会容易许多。
2、测试不要造成引脚间短路。电压测量或用示波器探头测试波形时,表笔或探头不要由于滑动而造成集成电路引脚间短路,最好在与引脚直接连通的外围印刷电路上进行测量。任何瞬间的短路都容易损坏集成电路,在测试扁平型封装的CMOS集成电路时更要加倍小心。
3、严禁在无隔离变压器的情况下,用已接地的测试设备去接触底板带电的电视、音响、录像等设备。严禁用外壳已接地的仪器设备直接测试无电源隔离变压器的电视、音响、录像等设备。虽然一般的收录机都具有电源变压器,当接触到较特殊的尤其是输出功率较大或对采用的电源性质不太了解的电视或音响设备时,首先要弄清该机底盘是否带电,否则极易与底板带电的电视、音响等设备造成电源短路,波及集成电路,造成故障的进一步扩大。
4、要注意电烙铁的绝缘性能。不允许带电使用烙铁焊接,要确认烙铁不带电,最好把烙铁的外壳接地,对MOS电路更应小心,能采用6~8V的低压电路铁就更安全。
5、要保证焊接质量。焊接时确实焊牢,焊锡的堆积、气孔容易造成虚焊。焊接时间一般不超过3秒钟,烙铁的功率应用内热式25W左右。已焊接好的集成电路要仔细查看,最好用欧姆表测量各引脚间有否短路,确认无焊锡粘连现象再接通电源。
6、不要轻易断定集成电路的损坏。不要轻易地判断集成电路已损坏。因为集成电路绝大多数为直接耦合,一旦某一电路不正常,可能会导致多处电压变化,而这些变化不一定是集成电路损坏引起的,另外在有些情况下测得各引脚电压与正常值相符或接近时,也不一定都能说明集成电路就是好的。因为有些软故障不会引起直流电压的变化。
7、测试仪表内阻要大。测量集成电路引脚直流电压时,应选用表头内阻大于20KΩ/V的万用表,否则对某些引脚电压会有较大的测量误差。
8、要注意功率集成电路的散热。功率集成电路应散热良好,不允许不带散热器而处于大功率的状态下工作。
9、引线要合理。如需要加接外围元件代替集成电路内部已损坏部分,应选用小型元器件,且接线要合理以免造成不必要的寄生耦合,尤其是要处理好音频功放集成电路和前置放大电路之间的接地端。
| 集成电路型号各部分的意义 |
| 第0部分 | 第一部分 | 第二部分 | 第三部分 | 第四部分 |
| 符号 | 意义 | 符合 | 意义 | 意义 | 符号 | 意义 | 符合 | 意义 |
| C | C表示中国制造 | T | TTL电路 | 用数字表示器件的系列代号 | C | 0~70℃ | F | 多层陶瓷扁平 |
| H | HTL电路 | G | ‐25~70℃ | B | 塑料扁平 |
| E | ECL电路 | L | ‐24~85℃ | H | 黑瓷扁平 |
展开表格其他信息
晶体管发明并大量生产之后,各式固态半导体组件如二极管、晶体管等大量使用,取代了真空管在电路中的功能与角色。到了20世纪中后期半导体制造技术进步,使得集成电路成为可能。相对于手工组装电路使用个别的分立电子组件,集成电路可以把很大数量的微晶体管集成到一个小芯片,是一个巨大的进步。集成电路的规模生产能力,可靠性,电路设计的模块化方法确保了快速采用标准化IC 代替了设计使用离散晶体管。
IC 对于离散晶体管有两个主要优势:成本和性能。成本低是由于芯片把所有的组件通过照相平版技术,作为一个单位印刷,而不是在一个时间只制作一个晶体管。性能高是由于组件快速开关,消耗更低能量,因为组件很小且彼此靠近。2006年,芯片面积从几平方毫米到350 mm2,每mm2可以达到一百万个晶体管。
第一个集成电路雏形是由杰克·基尔比于1958年完成的,其中包括一个双极性晶体管,三个电阻和一个电容器。
根据一个芯片上集成的微电子器件的数量,集成电路可以分为以下几类:
1.小规模集成电路
SSI 英文全名为 Small Scale Integration, 逻辑门10个以下 或 晶体管 100个以下。
2.中规模集成电路
MSI 英文全名为 Medium Scale Integration, 逻辑门11~100个 或 晶体管 101~1k个。
3.大规模集成电路
LSI 英文全名为 Large Scale Integration, 逻辑门101~1k个 或 晶体管 1,001~10k个。
4.超大规模集成电路
VLSI 英文全名为 Very large scale integration, 逻辑门1,001~10k个 或 晶体管 10,001~100k个。
5.甚大规模集成电路
ULSI 英文全名为 Ultra Large Scale Integration, 逻辑门10,001~1M个 或 晶体管 100,001~10M个。
GLSI 英文全名为 Giga Scale Integration, 逻辑门1,000,001个以上 或 晶体管10,000,001个以上。
而根据处理信号的不同,可以分为模拟集成电路、数字集成电路、和兼具模拟与数字的混合信号集成电路。
集成电路的发展最先进的集成电路是微处理器或多核处理器的"核心(cores)",可以控制电脑到手机到数字微波炉的一切。存储器和ASIC是其他集成电路家族的例子,对于现代信息社会非常重要。虽然设计开发一个复杂集成电路的成本非常高,但是当分散到通常以百万计的产品上,每个IC的成本最小化。IC的性能很高,因为小尺寸带来短路径,使得低功率逻辑电路可以在快速开关速度应用。
这些年来,IC 持续向更小的外型尺寸发展,使得每个芯片可以封装更多的电路。这样增加了每单位面积容量,可以降低成本和增加功能-见摩尔定律,集成电路中的晶体管数量,每两年增加一倍。总之,随着外形尺寸缩小,几乎所有的指标改善了-单位成本和开关功率消耗下降,速度提高。但是,集成纳米级别设备的IC不是没有问题,主要是泄漏电流(leakage current)。因此,对于最终用户的速度和功率消耗增加非常明显,制造商面临使用更好几何学的尖锐挑战。这个过程和在未来几年所期望的进步,在半导体国际技术路线图(ITRS)中有很好的描述。
越来越多的电路以集成芯片的方式出现在设计师手里,使电子电路的开发趋向于小型化、高速化。越来越多的应用已经由复杂的模拟电路转化为简单的数字逻辑集成电路。
IC的普及仅仅在其开发后半个世纪,集成电路变得无处不在,电脑,手机和其他数字电器成为现代社会结构不可缺少的一部分。这是因为,现代计算,交流,制造和交通系统,包括互联网,全都依赖于集成电路的存在。甚至很多学者认为有集成电路带来的数字革命是人类历史中最重要的事件。
IC的分类集成电路的分类方法很多,依照电路属模拟或数字,可以分为:模拟集成电路、数字集成电路和混合信号集成电路(模拟和数字在一个芯片上)。
数字集成电路可以包含任何东西,在几平方毫米上有从几千到百万的逻辑门,触发器,多任务器和其他电路。这些电路的小尺寸使得与板级集成相比,有更高速度,更低功耗并降低了制造成本。这些数字IC, 以微处理器,数字信号处理器(DSP)和单片机为代表,工作中使用二进制,处理1和0信号。
模拟集成电路有,例如传感器,电源控制电路和运放,处理模拟信号。完成放大,滤波,解调,混频的功能等。通过使用专家所设计、具有良好特性的模拟集成电路,减轻了电路设计师的重担,不需凡事再由基础的一个个晶体管处设计起。
IC可以把模拟和数字电路集成在一个单芯片上,以做出如模拟数字转换器(A/D converter)和数字模拟转换器(D/A converter)等器件。这种电路提供更小的尺寸和更低的成本,但是对于信号冲突必须小心。[1]
行业现状
随着全球半导体市场发展步伐的逐步拉大,现阶段,中国集成电路产业与国外相比差距较大,自身的创新力不足以及产业发展中埋伏的诸多隐患,使得中国集成电路产业面临着一系列的挑战。表现之一是产业链条上的相关企业多处于单兵作战状态,产业脱节的局面始终未得到重视和改观。集成电路产业是国家基础性、战略性、先导性产业,是电子信息产业的核心与基础,是一个国家经济发展、科技发展的重要标志。近年来,在旺盛的市场需求和技术发展的带动下,中国集成电路产业发展势头十分强劲。
2014年6月,全国集成电路产量为904,495.48万块,同比增长8.54%,2014年1-6月全国集成电路产量为4,711,807.45万块,同比增长9.18%。
2020年7月30日,国务院学位委员会会议投票通过集成电路专业将作为一级学科,并将从电子科学与技术一级学科中独立出来的提案。集成电路专业拟设于新设的交叉学科门类下,待国务院批准后,将与交叉学科门类一起公布。[2]
当地时间2022年6月23日,澳大利亚硅量子计算公司SQC宣布制造出世界上第一个原子级量子集成电路。[3]